— 产品分类 —
化学气相沉积技术的分类和简介
发布时间:
2025-01-14
化学气相沉积技术有多种分类方法。按激发方式可分为热化学气相沉积(TCVD)、等离子体化学气相沉积(PCVD)激光(激发)化学气相沉积等。按反应室压力可分为常压化学气相沉积、低压化学气相沉积等。按反应温度的相对高低可分为高温化学气相沉积、中温化学气相沉积、低温化学气相沉积。有人把常压化学气相沉积称为常规化学气相沉积,而把低压化学气相沉积、等离子体化学气相沉积、激光化学气相沉积等列为“非常规”化学气相沉积。
化学气相沉积技术有多种分类方法。按激发方式可分为热化学气相沉积(TCVD)、等离子体化学气相沉积(PCVD)激光(激发)化学气相沉积等。按反应室压力可分为常压化学气相沉积、低压化学气相沉积等。按反应温度的相对高低可分为高温化学气相沉积、中温化学气相沉积、低温化学气相沉积。有人把常压化学气相沉积称为常规化学气相沉积,而把低压化学气相沉积、等离子体化学气相沉积、激光化学气相沉积等列为“非常规”化学气相沉积。也有按源物质归类,如金属有机化合物化学气相沉积、氯化物化学气相沉积、氢化物化学气相沉积等。除了上述分类方法外,还经常按目前重要的、以主特征进行综合分类即分为热激发化学气相沉积、低压化学气相沉积、等离子体化学气相沉积、激光(诱导)化学气相沉积、金属有机化合物化学气相沉积等。下面就按这个分类方法分别介绍这几类化学气相沉积技术的概况。
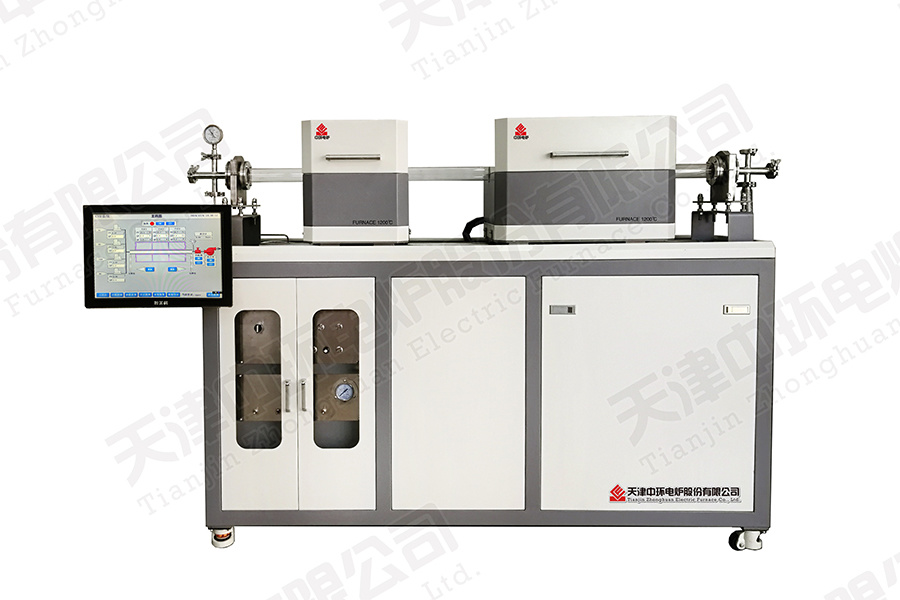
01
热化学气相沉积(TCVD)
热化学气相沉积(TCVD)法的原理是,利用挥发性的金属卤化物和金属的有机化合物等,在高温下发生气相化学反应,包括热分解、氢还原、氧化、置换反应等,在基板上沉积所需要的氮化物、氧化物、碳化物、硅化物、高熔点金属、金属、半导体等薄膜。在反应过程中,以气体形式提供构成薄膜的原料,反应尾气由抽气系统排出。通过热能(辐射、传导、感应加热等)除加热基板到适当温度之外,还对气体分子进行激发、分解,促进其反应。分解生成物或反应产物沉积在基体表面形成薄膜。
热化学气相沉积按其化学反应形式又可分为三类:化学输运法、热解法、合成反应法。其中:化学输运法虽然能制备薄膜,但一般用于块状晶基体生长;热解法通常用于沉积薄膜;合成反应法则两种情况都用。热化学气相沉积应用于半导基体和其他材料。广泛应用的化学气相沉积技术如金属有机化学气相沉积、氢化物化学气相沉积等都属于这个范围。
02
低压化学气相沉积(LPCVD)
低压化学气相沉积(LPCVD)是在常压化学气相沉积的基础上,为提高膜层质量,改善膜厚与电阻率等特性参数分布的均匀性,提高生产效率等而发展起来的。低压化学气相沉积的主要特征有:
(1)低压化学气相沉积的压力范围一般在0.0001x10的4次方~4x10的4次方Pa之间。由于低压下分子平均自由程增加,因而加快了气态分子的输运过程,反应物质在工件表面的扩散系数增大,使薄膜均匀性得到改善。对于表面扩散动力学控制的外延生长,可增大外延层的均匀性,这在大面积大规模外延生长中(例如,大规模硅器件工艺中的介质膜外延生长)是必要的。但是对于由质量输送控制的外延生长,上述效应并不明显。
(2)低压外延生长,对设备要求较高,必须有精确的压力控制系统,反应器采用扩散炉型,温度容易控制。在低压下更容易实现基片的均匀加热,特别是可以大批量地装载基片,从而可靠性及生产效率大幅度提高。低压外延有时是必须采用的手段,如当化学反应对压力敏感时,常压下不易进行的反应,在低压下变得容易进行。低压外延有时会影响分凝系数。
(3)由于Si基片垂直装载,即使硅圆片直径变大,也不影响其处理能力随着基片尺寸的进一步增大,为了抑制颗粒的产生,可采用纵型反应器。
03
等离子体化学气相沉积(PCVD)
PCVD法按加给反应室电力的方法可分为以下几类:
(1)直流法。利用直流电等离子体的激活化学反应进行气相沉积的技术称为直流等离子体化学气相沉积(DCPCVD)。它在阴极侧成膜,此膜会受到阳极附近的空间电荷所产生的强磁场的严重影响。用稀释反应气体时膜中会进入氩,为避免这种情况,将电位等于阴极侧基材电位的帘棚放置于阴极前面,这样可以得到优质薄膜。
(2)射频法。利用射频离子体激活化学反应进行气相沉积的技术称为射频等离子体化学气相沉积(RFPCVD)。供应射频功率的耦合方式大致分为电感耦合方式和电容耦合方式。在放电中,电极不发生腐蚀,无杂质污染,需要调整基材位置和外部电极位置。也采用把电极装入内部的耦合方式,特别是平行平板方式(电容耦合)在电稳定性和电功率效率上均显示优异性能,得到广泛应用,反应室压力保持在0.13Pa左右,基材与离子体之间加有偏压,诱导沉积在基材表面。射频法可用来沉积绝缘膜。
(3)微波法。用微波等离子体激活化学反应进行气相沉积的技术,称为微波等离子体化学气相沉积(MWPCVD)。由于微波等离子体技术的发展,获得各种气体压力下的微波等离子体已不成问题。现在有多种MWPCVD装置。例如,用一个低压化学气相沉积反应管,其上交叉安置共振腔及与之匹配的微波发射器,以 2.45GHz的微波,通过矩形波导人,使化学气相学积反应管中被共振腔包围的气体形成等离子体,并能达到很高的电离度和离解度,再经轴对称磁场打到基材上。微波发射功率通常在几百瓦至1kW以上,这可根据托盘温度和生长过程满足质量输运限速步骤等条件决定。这项技术具有下列优点:可进一步降低基材温度,减少因高温生长造成的位错缺陷、组分或杂质的互扩散;②避免了电极污染:③薄膜受等离子体的破坏小:4更适合于低熔点和高温下不稳定化公物薄膜的制备:⑤由于其频率很高,因此对系统内气体压力的控制可以大大放宽;⑥由于其频率很高,在合成金刚石时更容易获得晶态金刚石。除了上述的直流法、射频法、微波法三类外,还有同时加电场和磁场的方法为在磁场使用下增加电子寿命,有效维持放电,有时需要在特别低压条件下进行放电。
PCVD最早是利用有机硅化合物在半导体上沉积SiO2,后来在半导体工业上获得了广泛的应用,如沉积Si3N4、 Si、SiC、磷硅玻璃等。目前,PCVD 已不仅用于半导基体,还用于金属、陶瓷、玻璃等基材上,作保护膜、强化膜、修饰膜、功能膜。PCVD另两个重要应用是制备聚合物膜以及金刚石、立方化硼等薄膜,展现了良好的发展前景。
PCVD 技术与 TCVD 技术相比,具有以下特征。
(1)可以在更低的温度下成膜。如沉积TC、Ti(CN)、TiN 和 Si3N4的反应温度可分别在700K、550K、520K和530K下进行,而用常规化学气相沉积则分别要在1200K、1000K、900K和1200K以上。PCVD之所以能够在较低温度下进行,是因为在等离子体化学气相沉积的情况下,不是靠气体的温度使气体激发离解,而是等离子体中的电子的能量。大多数PCVD都是使用非平衡等离子体电子温度很高,而气体温度较低,甚至可以接近室温。在辉光放电的范围,所形成的等离子体的电子温度在1~10eV,足以打断气体原子间的化学键,实现气体的激发和离解,形成具有很高化学活性的离子和各种化学基团(原子团)。降低化学气相沉积反应的温度在技术应用上具有十分重要的意义,很多衬底材料,如铝或有机聚合物,如温度过高,前者就会熔化而后者可能分解或变质、脱气。有些金属和合金,在温度较高时则可能发生相变,结构变化所引起的体积变化造成的应力可能使膜层开裂或剥落。
在半导体工艺中所用的掺杂元素,如硼和磷,在温度超过 800℃时就会发生显著的扩散,使器件的性能变坏。采用等离子体可以很容易地在这些掺杂的衬底上沉积各种膜层。
(2)可以大大减小由于薄膜和衬底热膨胀系数不匹配所造成的内应力。
(3)即使对于采用热过程难以成膜的反应速率极慢的物质,也可以采用PCVD技术在一定的沉积速率下成膜。这是因为在多数PCVD的情况下(辉光放电)所用的压力较低,增强了反应气体和生成气体产物穿过边界层在平流层和衬底表面之间的质量输运,而且使膜厚均匀性也得到改善。低沉积温度有利于得到非晶态和微晶薄膜,而非晶态或微晶薄膜往往具有独特的优异性能。此外,对于热分解温度不同的物质,也可以按不同的组成比合成。PCVD也有不足之处。其一是在等离子体中,电子的能量分布范围很宽,除电子碰撞外,在离子碰撞作用和放电时产生的射线的作用下也可产生新粒子,因此 PCVD反应未必是选择性的,很可能同时存在几种化学反应,使反应产物控制变得困难,反应机理也往往难于解释。因此,采用PCVD 难于得到纯净的物质由于沉积温度较低,反应产生的副产物气体和其他气体的解吸进行不彻底,往往残留在沉积的薄膜中(特别是氢)。而在化合物(如碳化物、氮化物、氧化物、硅化物等)沉积的情况下,很难保证准确的化学计量比。一般情况下,这是不利的,将改变其物理、化学性质,降低抗腐蚀性和抗辐射能力。其二,PCVD 往往倾向于在薄膜中造成压应力。对于在半导体工艺中应用的超薄膜来讲,应力还不至于造成太大的问题。对冶金涂层来讲,压应力有时反而是有利的。但涂层较厚时应力有可能造成涂层的开裂和剥落。PCVD另一缺点是对某些脆弱衬底如半导体工艺中用的Ⅲ-V族和Ⅱ-Ⅵ族化合物半导体材料,容易造成离子轰击损伤(特别是当离子能量超过20eV时)。此外,等离子体可能和沉积中的涂层表面有强烈的作用,这意味着薄膜沉积速率及薄膜的性质依赖于等离子体的均匀性。最后,PCVD装置一般来讲较复杂,价格也较高。
总的说来,PCVD的优越性是主要的,现在正获得越来越广泛的应用。
04
金属有机化合物化学气相沉积(MOCVD)
金属有机化合物是一类含有碳-金属键的物质。它要适用于MOCVD法,应具有易于合成和提纯,在室温下是液体并有适当的蒸气压、较低的热分解温度对沉积薄膜沾污小和毒性小等特点。现以生长亚-V族化合物为例。载气高纯氢通过装有Ⅲ族元素有机化合物的鼓泡瓶携带其蒸气与用高纯氢稀释的V族元素氢化物分别导入反应室,衬底放在高频加热的石墨基座上,被加热的衬底对金属有机物的热分解具有催化效应,并在其上生成外延层,这是在远离热平衡状态下进行的。在较宽的温度范围内,生长速率与温度无关,而只与到达表面源物质量有关。
MOCVD 技术所用的设备包括:温度精确控制系统、压力精确控制系统、气体流量精确控制系统、高纯载气处理系统、尾气处理系统等。为了提高异质界面的清晰度,在反应室前通常设有一个高速、无死区的多通道气体转换阀;为了使气体转换顺利进行,一般设有反应气路和辅助气路,两者气体压力要保持相等。
根据MOCVD生长压力的不同,又分为常压MOCVD和低压MOCVD。将MOCVD与分子束外延(MBE)技术结合,发展出金属有机化合物分子束外延(MOMBE)和化学束外延(CBE)等技术。
与常规化学气相沉积相比,MOCVD的优点是:沉积温度低:②能沉积单品、多晶、非晶的膜层和超薄层、原子层薄膜;③可以大规模、低成本制备复杂组分的薄膜和化合物半导基体材料:④)可以在不同基材表面沉积:⑤每一种或增加一种MO源可以增加沉积材料中的一种组分或一种化合物,使用两种或更多MO源可以沉积二元或多元、二层或多层的表面材料,工艺的通用性较广MOCVD的缺点是:沉积速度较慢,仅适宜于沉积微米级的表面层:原料的毒性较大,设备的密封性、可靠性要好,并谨慎管理和操作。
05
激光激发化学气相沉积(LCVD)
LCVD与常规化学气相沉积相比,可以大大降低基材的温度,防止基材中杂质分布受到破坏,在不能承受高温的基材上合成薄膜。例如,用TCVD制备SO2、S3N4、AIN 薄膜时基材需加热到 800~1200℃,而用LCVD 则需 380~450℃。LCVD与PCVD相比,可以避免高能粒子辐照在薄膜中造成的损伤。由于给定的分子只吸收特定波长的光子,因此,光子能量的选择决定了什么样的化学键被打断,这样使薄膜的纯度和结构就能得到较好的控制。
相关新闻



